AiEYE ADC는 SEM 이미지와 Wafer Map을 Ai로 분석하여 분당 180개 이상의 결함을 찾아내고 분류하는 자동 결함 분류 솔루션입니다.
AI 기술과 반도체 공정 현장의 다양한 학습데이터로 완성한 AiEYE ADC는
결함 원인 분석을 위한 핵심 도구로 공정 수율 향상과 비용 절감의 열쇠를 제공할 것입니다.
결함 발견, 분류는 반도체 공정의 수율 향상 및 비용 절감의 선결 조건입니다. 결함의 원인 분석해내고 해결하는 것은 지난한 일이고 지금까지의 자동화 기술은 한계가 있었습니다.
소프트온넷은 고객 신뢰를 바탕으로 축적된 Ai 영상분석 기술력과 Ai 활용 방법론을 적용하여 저지연, 고성능, 고속도의 AiEYE ADC 솔루션을 개발하였습니다.
-

-
SEM 이미지와 Wafer Map
동시 지원AiEYE ADC는 소프트온넷의 AiEYE 플랫폼을 기반으로 SEM 이미지를 분석하는 Layered Defector Classfier와 Wafer Map의 결함을 분류하는 Wafer Map Classifier를 통합하여 지원합니다.
-

-
정확하고 빠른
AiEYE 분석 성능AiEYE ADC는 Wafer Map의 결함을 98% 정확도로 분류해냅니다. 딥러닝 기술이 적용된 분석 모델은 분당 180개의 결함을 발견하고 분류할 수 있습니다.
-

-
지속적 성능 개선을 위한
학습 시스템 통합공정의 개선과 수율 향상을 위해서는 결함 발견 능력의 지속적인 향상이 필요합니다.
AiEYE ADC는 결함 발견/분류 시스템 뿐만아니라 딥러닝 학습시스템을 포함하여 분석 모델의 결함 발견 및 분류 성능을 지속적으로 향상할 수 있도록 지원합니다.

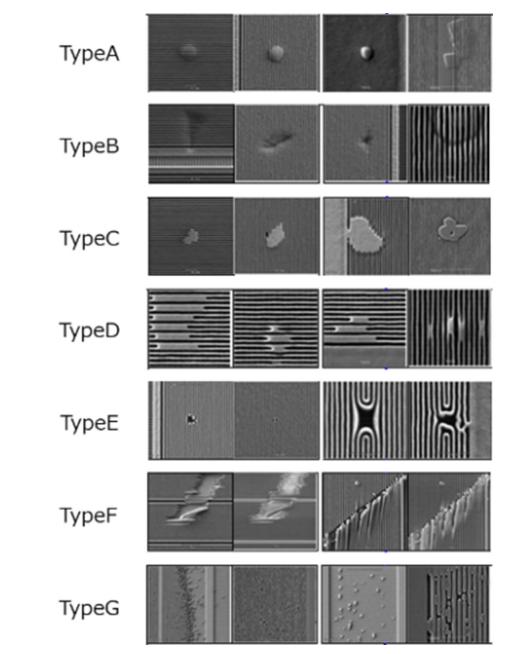
소프트온넷의 Ai 영상분석 기술력과 기술 활용 방법론이 통합된 AiEYE ADC는
보다 저렴한 비용으로 Wafer 결함 발견, 분류방식을 자동화할 수 있는 기회를 제공하고 있습니다.
-

-
중앙 집중형 판독
AiEYE ADC는 무정지 서비스와 부하 분산을 고려하여 중앙 집중형 판독을 채택하고 있습니다.
GPU를 장착한 하나 이상의 서버에서 결함 발견 및 분류를 수행하여 최적의 성능을 사용자에게 제공합니다.
-

-
웹 기반 사용자 인터페이스
사용자는 분류된 결함을 웹 기반의 화면으로 확인할 수 있습니다.
AiEYE 플랫폼의 사용자 관리 정책을 적용하여 사용자에게 할당된 라인의 판독결과만 표시할 수 있습니다.
-

-
보다 손쉬운
공정 솔루션 연동분석(결함 발견,분류)과 사용자 인터페이스를 분리한 AiEYE는 이 구조적 특징 덕분에 보다 손쉽게 기존의 공정 솔루션과 결합할 수 있습니다.
-

-
무정지 분석 모델 배포
결함 발견은 생산 라인의 돌아가고 있는 동안 계속 진행되어야 합니다.
AiEYE ADC는 도커 기반의 관리로 학습 시스템에서 생성된 분석 모델을 서비스 중단없이 배포하고 갱신하여 새로운 분석 모델을 곧바로 라인에 적용 합니다.
